Home / Technologie
Technologische möglichkeiten großserie
Kleiner Bohrdurchmesser
0,2mm
Max. Verhältnis Platinenstärke / Durchmesser (aspect ratio)
bis zu 12 : 1
Sacklöcher (mechanisch gebohrt)
Sacklöcher (gelasert)
75 – 150 µm, ca. 1:1 aspect ratio (abhängig vom Prepregtyp)
Dünnstes Innenlagenmaterial
50 µm (dünnste durchkontaktierte Innenlage 150 µm inkl. Kupfer)
Geringste Multilayer-Dicke
6-Lagen: 0,65 mm
Max. Dicke
3,2 mm
Iso-Abstände


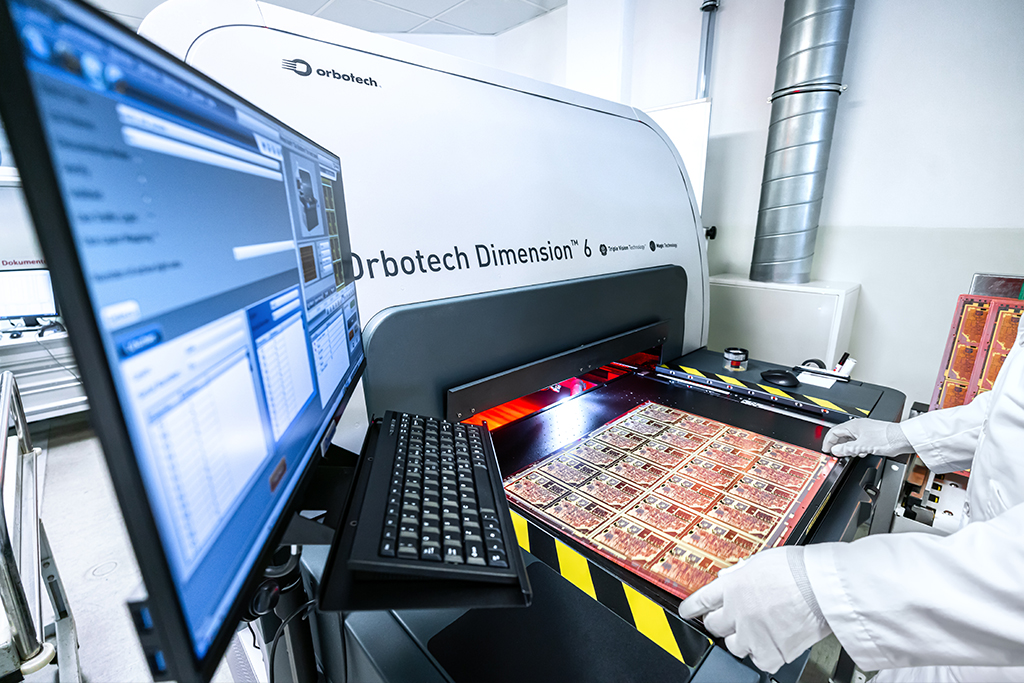
Sondertechnologie
- HDI/SBU bis zu 4
- Microvia-Lagen (4+x+4)
Microvia-Filling - Hole-plugging-Verfahren (mit Harz gefüllte vergrabene Bohrungen)
- Bondbare Oberflächen für COB (eigenes Bondlabor für Oberflächenanprobe)
- Impedanzkontrollierte Leiterplatten für Hochfrequenz-Anwendungen
- Hybridtechnik, Kombination verschiedener Materialien (z.B. Teflon/FR4)
- Tiefenfräsen, z.B. zur vertikalen Integration von Bauteilen
- Thermomanagement, z.B. Dickkupfertechnik bis 210 μm
- Starrflex-Schaltungen mit ausgewählten Aufbautena
Meilensteine - Technologie
1994
Einführung Oberfläche:
Chemisch Nickel/Gold
1999
Einführung SBU-Technik
Microvias mechanisch gebohrt
2008
Installation einer neuen Chemisch Nickel/Gold-Anlage
(2. Generation)
2012
Installation eines LDI-Belichters zur Verbesserung des Imagetransfers
2014
Inbetriebnahme einer ressourcenschonenden Energieversorgung (BHKW, effiziente Kälte-maschinen und emissionsarme Gasheizungen
2015
Installation einer modernen horizontalen Durchkontaktierungs-anlage
2018
Erweiterung der Inhouse Microvia-Filling Kapazität und Technologien
2019
Ausbau Digitalisierung
Imagetransfer
2020
Digitalisierung Lötstopplackprozess
2022
Kapazitätserweiterung




